新型膨松剂对各种PCB基材咬蚀形貌的研究
发布日期:2019-05-04
文/深圳市正天伟科技有限公司
作者 陈良 卢进辉

第一作者简介
陈良,高级工程师(行业职称),长期从事于印制电路工艺技术研究、研发及相关技术管理工作,现就职于深圳市正天伟科技有限公司。
摘要:
介绍印制电路板在除胶渣过程中,因膨松剂原因导致孔壁树脂咬蚀异常,从而引发电镀铜层与孔壁结合力不良,导致孔壁分离等品质问题的发生。从而引起重视,预防孔壁分离品质隐患及问题的发生。
关键词:膨松剂;除胶渣;孔壁分离;咬蚀形貌;PCB。
Study on the micro-rough of various PCB material
by a new type of swelling agent
Chen Liang LU Jinhui
Abstract This paper introduces that in the process of de-smear the printed circuit board (PCB), the hole wall resin corrosion is abnormal due to the swelling agent. To provide reference for PCB manufacturers, so as to attract attention and prevent the hole wall separation quality hidden trouble and problems.
Key words Swelling agent, De-smear, Hole wall separation, Micro-rough, PCB.
一 前言
电子化学品是印制电路板制造过程中不可缺少的关键物料,也是印制电路制造过程中品质保证的关键因素所在。在印制电路板钻孔后的除胶渣工序,对除钻污效果,印制电路制造厂商往往通过除钻污量来评估除胶的效果,而忽视了本制程的关键控制点---孔壁树脂咬蚀形貌是否为蜂窝状。
二 背景
收到一印制电路板制造厂商的朋友求助,其产品在制程中检测发现偶尔有发生孔铜分离的现象,个别批号的产品特别严重。该印制电路板制造厂商以前也发生过类似问题,但大部分是发生在不过除胶渣流程的双面板上,为了彻底杜绝类似问题的发生,其制作流程已作优化处理,无论双面板还是多层板,都经除胶渣流程,防止钻污除去不净导致孔壁铜层分离或发生其它品质问题隐患。
三 问题原因
不良产品金相切片如图1,孔壁与铜层已经全部分离(圆圈内):

图1 不良产品金相切片图
首先,我们查询并验证了钻孔工序的相关参数,均为正常,且产生钻污量在正常水平,不会因为钻孔参数控制不当产生大量的钻污导致除钻污不彻底;其次,查询该板生产时的除胶渣工序参数均正常,除胶量为0.35mg/c㎡,属于正常范围(除胶量一般控制在0.1-0.5 mg/c㎡)。钻孔工序产生的钻污正常,除胶量也控制在正常范围,为何还是会发生孔壁铜层分离呢?这给电子化学品制造商出了个研究课题。
四 分析过程
4.1经查实,发生孔壁分离问题的产品均使用南亚NPG150N基材,取该型号已过除胶渣工序的产品,分析其除胶量均在0.2-0.4 mg/c㎡之间,做SEM(Scanning Electron Microscope)分析,分析图如下:
|
|
|
|
生产本型号产品的基材均为南亚NPG150N,从以上SEM图片看出(图2、图3),经过除胶渣工序后,树脂未形成均匀蜂窝状,且有大块树脂存在。但玻纤处的钻污已除净(图4、图5),试验把除胶量加大到0.5-0.6 mg/c㎡之间,树脂处SEM图显示并无改善(如图6)。

图6 基材 NPG150N除胶渣后树脂处SEM
4.2很明显,该型号膨松剂对南亚NPG150N基材树脂层的咬蚀形貌有异常,但对于其它型号基材的咬蚀形貌均合格。研发对膨松剂进行了一系列的改良,在DOE试验确定各最优参数后,对南亚NPG150N基材树脂层SEM检测,发现改良后的膨松剂对该基材的树脂面咬蚀状况良好,见图7:
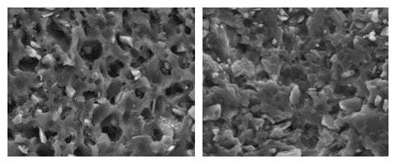
图7 基材NPG150N除胶渣改良后树脂处SEM
4.3试验不同的膨松剂对各种常规基材的除胶量,从除胶量的稳定性来看,我们选择膨松剂D,可以控制各种基材的除胶量在比较合适的水准(如图8)。

图8 不同膨松剂对各种常规基材的除胶量对比图
4.4 膨松剂机理:
除胶渣工序流程:膨松—双水洗—除胶—双水洗—预中和—双水洗—中和—双水洗。
膨松剂的功能和机理:软化和膨松环氧树脂,降低高分子聚合物分子间的键能,使高锰酸钾更易咬蚀形成蜂窝状。传统膨松剂配方由醇醚、烷基乙酰胺、环氧乙烯环氧丙烯共聚物等组成,并添加一定量的表面活性剂来降低溶液表面张力,使溶液能更好的渗透到基材内壁,软化孔内壁附着的胶渣,进而膨松并渗入到树脂交联聚合处,降低其键能,便于胶渣更容易被氧化清除。不同基材需采用不同的膨松剂,传统的膨松剂主要针对FR-4等常规的PCB基材。
蜂窝形成机理:添加一定分子量的阴离子表面活性剂、柔软剂及湿润剂成分(如聚乙二醇等),初期溶出时可降解较弱的键结,使其键结间有了明显的差异;如浸泡时间过长,强的链接也逐渐降低,终使整块成为低链接能的表面,此时将无法形成不同强度的结面;如浸泡时间过短,则无法形成低键结及键结差异。
4.5 新型膨松剂D相比传统的膨松剂,通过添加系列表面活性剂等,可使之达到优良的回蚀效果,且能改善其亲水性,使下一步高锰酸钾的除胶渣效果更为优异,改善了其与基材树脂层的物理及化学反应速率,促成与基材树脂层咬蚀成蜂窝状形貌的形成。从以下各种SEM图(图9-图13)可看出,新型膨松剂D处理各种基材的效果良好,未发现基材树脂层咬蚀形貌有异常。
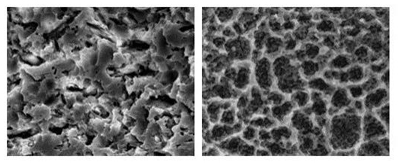
图9 南亚基材NP155F(左)和NP140(右) SEM图

图10 建滔基材TG140(左)和6160C(右) SEM图
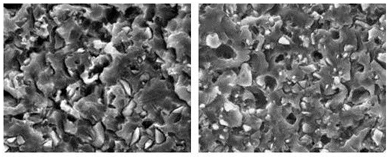
图11 生益基材无卤素(左)和Tg150(右) SEM图
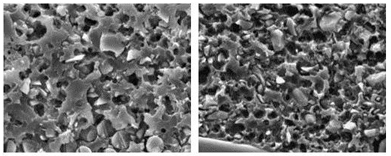
图12 腾辉基材VT-48(左)和VT-425(右) SEM图
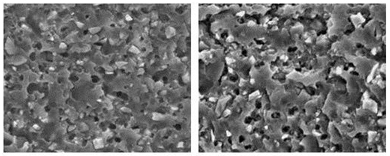
图13 宏仁基材无卤素(左)和联茂基材IT158(右) SEM图
五 总结及预防
1、除胶渣段流程中,品质的关键控制点是在膨松缸,而不是除胶渣缸;
2、膨松剂D能解决南亚及相关基材的树脂层咬蚀形貌异常的问题,预防因为孔壁树脂咬蚀形貌未形成蜂窝状导致的孔壁铜层分离;
3、新型基材的使用,因其树脂填料成分的不同,需要做相应的检测,验证是否与膨松剂相匹配,否则有可能造成树脂层咬蚀不良造成孔壁铜层分离;
4、对于新型填料的基材,只要确定填料的主要成分,均可以快速的找到相应的促进剂或树脂溶胀剂加入膨松剂中,达到较好的回蚀效果,预防树脂层不能被咬蚀成蜂窝状的情况发生。
参考文献
[1]林金堵,梁志立,邬宁彪,龚永林,陈培良.现代印制电路先进技术(第三版).中国印制电路行业协会(CPCA),印制电路信息杂志社,2013.2.
[2]曹权根,张鑫梁,刘金峰.等离子去钻污参数优化研究.印制电路信息,2018增刊,总第316期.
[3]王颖,黄扬扬,黎坊贤,卢意鹏.水平沉铜工艺药水参数优化探究.印制电路信息,2018增刊, 总第316期.
[4]程静,汪浩,杨琼,吴培常.除钻污机理、缺陷类型及改良措施.印制电路信息,2012.5,总第229期.
[5]刘仁志.现代电镀手册.化学工业出版社,2010.



 图2基材NPG150N树脂处SEM
图2基材NPG150N树脂处SEM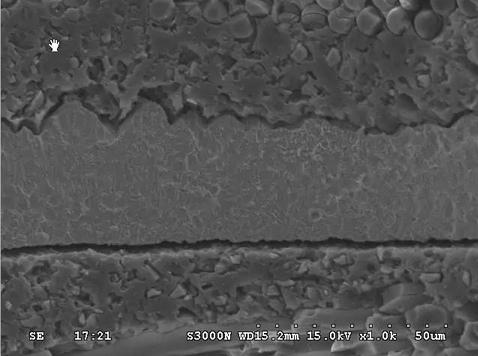 图3基材NPG150N内层铜SEM
图3基材NPG150N内层铜SEM 图4基材NPG150N玻纤处SEM
图4基材NPG150N玻纤处SEM 图5基材NPG150N 玻纤处SEM
图5基材NPG150N 玻纤处SEM